研究所装置一覧
リソグラフィー
感光性の材料(レジスト)をウェハに塗布し、光や電子ビームを照射してパターンを形成します。
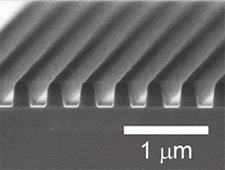
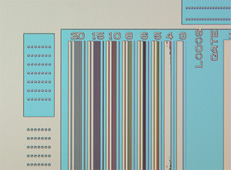
-
電子ビーム露光装置 (日立 HL700)
可変成形型,加速電圧:50 kV,最小線幅:50 nm
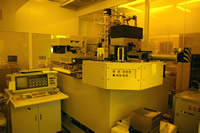
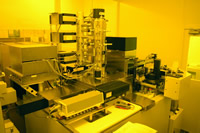
-
電子ビーム露光装置 (日本電子 JBX5D)
ポイントビーム型,加速電圧:25 kV or 50 kV,最小線幅:30 nm
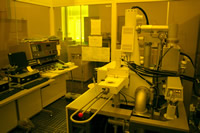
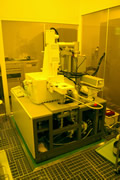
-
i線ステッパー (Nikon NSR i8a)
最小線幅:350 nm
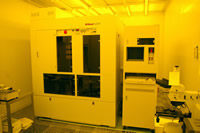
薄膜形成
高温の炉にシリコンウェハを入れ、酸素を流して表面を酸化したり(熱酸化)、堆積させたい膜の組成を持つガスを流して高温での熱分解や反応によりウェハ上に薄膜を形成(化学気相成長、CVD)させます。また薄膜としてつけたい金属に、希ガス元素を衝突させて金属原子をはじき飛ばし、ウェハ上に成膜する方法(PVD)などもあります。
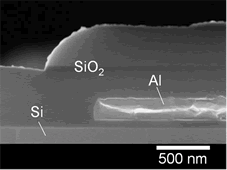
-
酸化炉 (東京エレクトロン)
パイロジェニック酸化可能,最高使用温度:1150 ℃
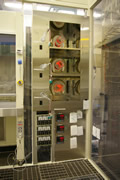
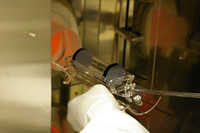
-
減圧CVD装置 (東京エレクトロン)
SiO2,SiN,Poly-Si用

-
常圧CVD装置 (天谷製作所)
SiO2用,基板温度:400 ℃,PおよびBドープ可能
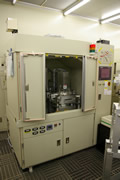
-
プラズマCVD装置 (アルバック)
SiN,アモルファスSi用
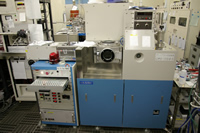
-
Alスパッタリング装置 (エイコー)
Al,Ti,TiNのスパッタリングが可能,
超高真空仕様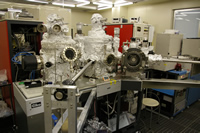
-
汎用スパッタリング装置 (エイコー)
各種材料スパッタ用,
2インチターゲット交換により広範な材料に対応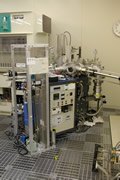
ドライエッチング
リソグラフィーで形成したレジストパターンをマスクにして、さまざまな薄膜を加工します。 ガスによる化学的反応を利用したり、加速したイオンを衝突させてエッチングを行います。


-
Si ECR (神戸製鋼)
Siエッチング用,30 nm加工実績有り

-
SiO2 RIE (神戸製鋼)
SiO2エッチング用
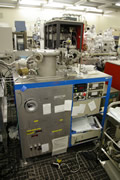
-
Al マグネトロンRIE (神戸製鋼)
Alエッチング用
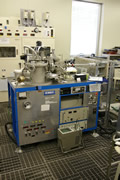
-
Al ICPエッチング装置 (YOUTEC)
Alエッチング用
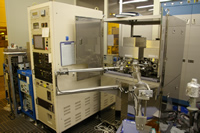
-
ケミカルドライエッチング装置 (神戸製鋼)
SiNエッチング用

-
アッシング装置 (神戸製鋼)
フォトレジスト除去用
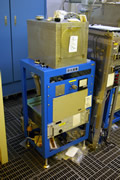
-
SiO2 ICPエッチング装置 (アユミ工業)
SiO2エッチング用
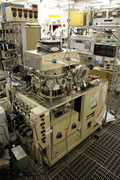
-
Poly-Si ICPエッチング装置 (YOUTEC)
Poly-Siエッチング用
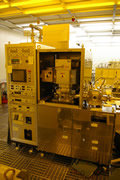
イオン注入・アニール
シリコンやポリシリコンなどに、ボロンやリンなどの不純物を注入したり、拡散させます。 イオン注入の後には、結晶格子を直したり不純物原子が電気的になじむよう高温の熱処理が必要になります。
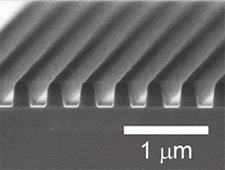
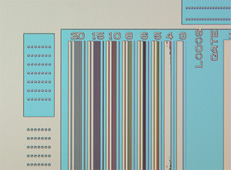
-
イオン注入装置 (アルバック)
中電流,エネルギー:5keV-150keV


-
リン拡散炉,PMA炉 (神港精機)
最高使用温度:900 ℃
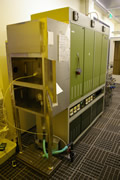
-
ウェル拡散炉,イオン注入後アニール炉(東京エレクトロン)
最高使用温度:1150 ℃
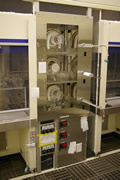
-
高速熱処理装置 (サムコ)
昇温最大速度:200 ℃/s
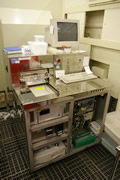
-
汎用熱処理装置 (光洋サーモシステム)
各種材料アニール用 (400-1000 ℃)
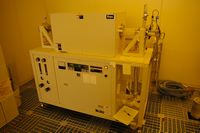
MEMS関連
MEMS(Micro Electro Mechanical Systems)のプロセスに対応した装置です。

-
マスクレス露光装置
(ナノシステムソリューションズ)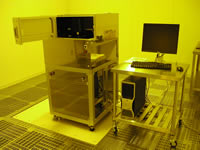
-
表面活性化接合装置 (エイコー)
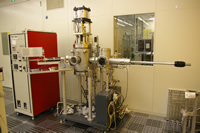
観察・測定用機器
微細加工したサンプルの形状を観察したり、成膜した材料の組成や表面の凹凸の様子、 屈折率などを調べることができます。
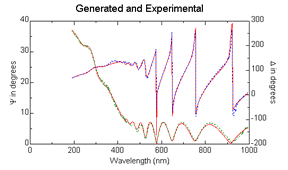
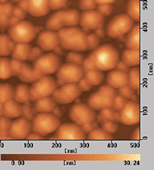
-
透過電子顕微鏡
電界放出型,
加速電圧:200 kV,格子分解能:0.102 nm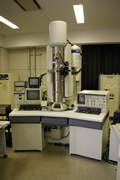
-
走査電子顕微鏡 (日立)
冷陰極電界放出型電子銃,最高分解能:1.5 nm

-
2次イオン質量分析計 (アルバックファイ)
Cs,Oガン装備四重極型質量分析器
一次イオン最小加速エネルギー:1 keV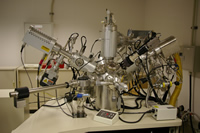
-
原子間力顕微鏡 (セイコーインスツルメンツ SPI3800)
分解能: z方向:0.01 nm,x, y方向:0.1 nm
視野:最小 5 nm角、最大 20 μm角
-
エリプソメータ (タイラン)
測定可能最小膜厚:10 nm

-
分光エリプソメータ (ジェー・エー・ウーラム・ジャパン)
測定可能最小膜厚:10 nm
分光波長範囲:193 nm – 1000 nm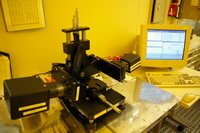
-
X線光電子分光分析装置 (VG Scienta ESCA-300)
分光器半径:300 mm,X線パワー:4 kW
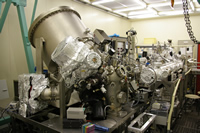
デバイス・回路設計
CADを用いてMOSデバイスや情報処理システムの設計などを行います。

-
設計用ワークステーション
Cadence, Synopsys,Mentor,Silvaco,Jedatなどの主要CADベンダーのCADツールを搭載した高性能ワークステーション,及び,大容量RAIDディスクシステム (Sun Blade,Sun fire,HP ProLiantなど)

